FCQFN
- 產(chǎn)品
- FCQFN
產(chǎn)品介紹
FCQFN全稱Flip Chip Quad Flat No – lead Package直譯過(guò)來(lái)就是即倒裝芯片四方扁平無(wú)引腳封裝,是在 QFN 封裝基礎(chǔ)上發(fā)展起來(lái)的一種先進(jìn)封裝技術(shù)。
產(chǎn)品特點(diǎn)
電氣性能優(yōu)越
信號(hào)傳輸高效:倒裝芯片結(jié)構(gòu)使芯片與封裝間的電氣連接路徑短,信號(hào)傳輸延遲小,高頻特性好,減少了信號(hào)反射與串?dāng)_,適用于 5G 通信、高速數(shù)據(jù)傳輸?shù)葘?duì)信號(hào)處理速度和穩(wěn)定性要求高的領(lǐng)域。
低電阻與低電感:無(wú)引腳設(shè)計(jì)及內(nèi)部結(jié)構(gòu)優(yōu)化,降低了引腳電感和電阻,自感系數(shù)以及封裝體內(nèi)布線電阻很低,能有效減少信號(hào)傳輸過(guò)程中的能量損耗,提高電路效率。
散熱性能良好
大面積散熱通道:底部的大面積裸露熱墊,可直接焊接到系統(tǒng) PCB 上,為芯片提供了良好的散熱通道,能快速將芯片產(chǎn)生的熱量散發(fā)出去,避免芯片因過(guò)熱性能下降或損壞。
熱阻低:與傳統(tǒng)封裝相比,F(xiàn)CQFN 封裝的熱阻明顯更低,可有效降低芯片工作溫度,提高芯片的可靠性和使用壽命,滿足高功率器件的散熱需求。
封裝尺寸小巧
占用空間小:無(wú)引腳設(shè)計(jì)和緊湊的結(jié)構(gòu),使 FCQFN 封裝的體積小,占用 PCB 板面積少,有利于實(shí)現(xiàn)電子設(shè)備的小型化和輕薄化,在智能手機(jī)、可穿戴設(shè)備等對(duì)空間要求苛刻的產(chǎn)品中優(yōu)勢(shì)明顯。
輕薄化:整體重量輕,符合現(xiàn)代電子設(shè)備輕薄化的發(fā)展趨勢(shì),對(duì)便攜式電子設(shè)備的續(xù)航和便攜性有積極影響。
應(yīng)用
手機(jī)、平板電腦、筆記本電腦等,用于電源管理芯片、無(wú)線通信芯片、音頻芯片等
工藝特點(diǎn)
倒裝芯片貼裝精度要求高
采用倒裝芯片技術(shù),需要高精度的設(shè)備和工藝來(lái)確保芯片倒裝貼裝的準(zhǔn)確性和一致性。在凸點(diǎn)制作、芯片對(duì)準(zhǔn)和焊接等環(huán)節(jié),對(duì)工藝控制要求嚴(yán)格,以保證芯片與封裝基板之間的電氣連接和機(jī)械穩(wěn)定性。例如,需要精確控制凸點(diǎn)的高度、形狀和位置,以及芯片與基板之間的對(duì)準(zhǔn)精度,通常要求達(dá)到微米級(jí)甚至更高的精度。
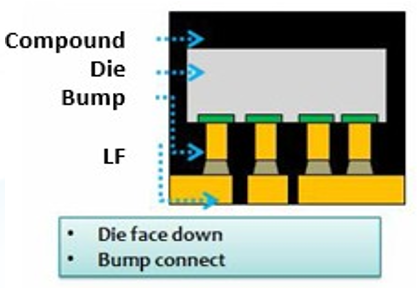
| item | FCOL Model PKG |
|---|---|
| Electrical | Faster speed Lower impedance |
| Heat Dissipation | Faster heat dissipation |
| Reliability | High reliability |
| I/O | More pins |
| PKG Size | Smaller packaging size |
| 封裝類型 Package Type | 封裝外形 Package Model | 封裝厚度 Package Height | 引腳間距 Lead Pitch | 框架尺寸 Lead Frame Size(mm) |
|---|---|---|---|---|
| FCQFN | FCQFN16L/20L/ 24L/28L | 0.75/0.5 | 0.4/0.5/0.65 | 258*78/250*70(4B) |


